上海光源软X射线干涉光刻最新进展
-
摘要:
综述 ● 开放获取阅读更多
1.文章导读
同步辐射不但在物理、材料、生命科学等研究中发挥着重要的作用,而且还在极端制造领域发挥着自己独特的作用。吴衍青研究员介绍了上海同步辐射光源(简称上海光源)以软X射线干涉光刻技术(简称XIL技术)为核心的极端制造技术的最新进展。在微纳制造领域,XIL是一种独立于主流极端制造技术的独特并行制造技术。它专注于制造严格周期的图案。此外,还可以有效地获得大面积的高分辨率纳米结构。该技术目前已广泛应用于极紫外(EUV)光刻胶检测、纳米光学和纳米磁学等研究领域。中国科学院上海高等研究院/中国科学院上海应用物理研究所的吴衍青研究员、邰仁忠研究员、赵俊、杨树敏、薛超凡等作者在《极端制造》(International Journal of Extreme Manufacturing, IJEM)创刊号上发表《上海光源软X射线干涉光刻最新进展》综述,系统介绍了软X射线干涉光刻技术的研究背景、最新进展及未来展望。
2.研究背景
软X射线干涉光刻(XIL)技术是利用两束或多束相干软X射线光束的干涉条纹对光刻胶进行曝光的新型先进微、纳加工技术,可以开展几十甚至十几个纳米周期的纳米结构加工。与其他光刻等方法相比,XIL技术具有分辨率高、无邻近效应、无污染、产出高等优点,可以更可靠地获得大面积、高质量的亚50nm的高密度周期性纳米结构。上海光源软X射线干涉光刻线站于2013年对用户开放。该线站的建设,旨在利用利用软X射线低发射度、高亮度和高相干性的优点,在上海光源建立一个高效率、低成本、高精度的纳米加工技术平台。国际上,瑞士光源的XIL-II线站和日本New SUBARU光源的BL-9线站都基于该技术也开展了大量的相关研究工作。吴衍青研究员将上海光源XIL线站在该项技术发展上最近所做的相关工作逐一地进行了详细的介绍。
3.最新进展
上海光源软X射线干涉光刻线站基于激光干涉仪,建立起一套精确的振动评估系统。曝光系统振动情况的量化评估为后续的减振手段提供了指引,最终将实验站曝光系统的振动控制在RMS值2.5 nm以下,为干涉曝光实验奠定了良好的硬件基础。在此基础上,该线站发展了高级次衍射干涉光刻、大面积拼接深度曝光和并行直写泰保光刻等实验方法。提升了线站的曝光分辨率、曝光深度和曝光面积等指标,还实现了复杂周期性图形的曝光。
高级次衍射干涉光刻方法 是采用二级及其以上级次衍射光束进行干涉光刻的曝光方法,可以实现曝光图案周期相对于原掩膜光刻周期1/4的倍缩。如图1所示。 目前图案半周期(HP)约25nm。该技术已用于EUV光刻胶检测。
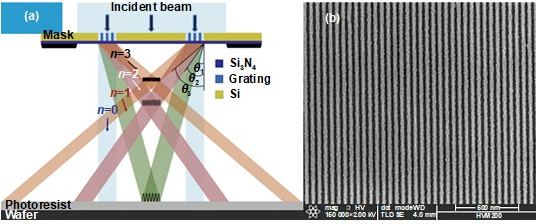
图1 高级次衍射干涉光刻方法(a)高级次衍射干涉光刻的原理图(b)采用高级次衍射干涉光刻获得HP=25nm的光刻胶周期图案的SEM图
大面积拼接深度曝光方法 一种基于高次谐波在线对准的大面积拼接深度曝光技术,如图2所示。采用该方法,用户能在硅、氮化硅或YAG晶体等衬底上快速制备大面积(平方厘米级)的纳米周期图案。
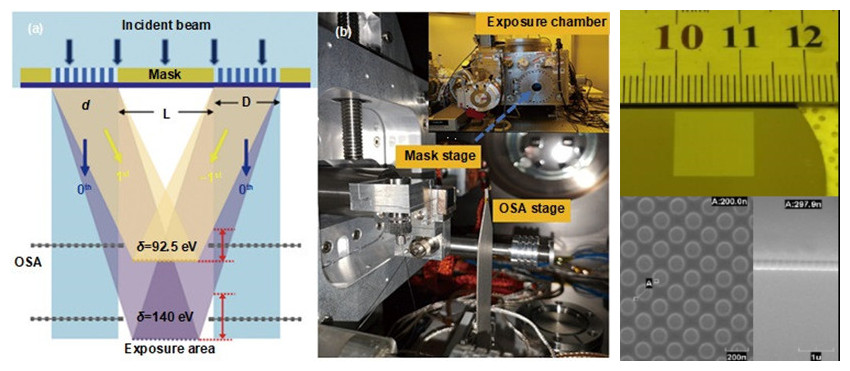
图2 大面积拼接深度曝光方法(a)方法原理图(b)实验装置图(c)实验结果
EUV并行直写泰保光刻方法 讲述了一种基于纳米位移平台的并行直写光刻方法,以实现复杂单元严格周期图案的曝光。如图3所示。该技术可用于超表面研究及应用。
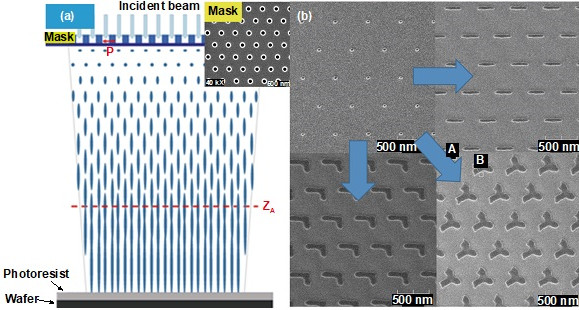
图3 并行直写泰保光刻方法(a)方法原理图(b)制备的复杂单元纳米周期性图案
4.未来展望
极紫外光刻胶是极紫外光刻技术的一个重要组成部分,也是国内的一个研究热点和急需解决的“卡脖子”技术之一。软X射线干涉光刻技术应用于极紫外光刻胶的检测是目前国际上最先进的表征方法,该方法将在极紫外光刻胶的研发中将发挥重要作用。上海光源基于软X射线干涉光刻线站已初步建立起极紫外光刻胶敏感度、分辨率、边缘粗糙度及曝光产气等重要指标检测的完整极紫外刻胶评估检测平台,来自国内的多个研究课题组已基于该平台开展了大量的工作,并已取得了一些显著的进展。如图4所示。
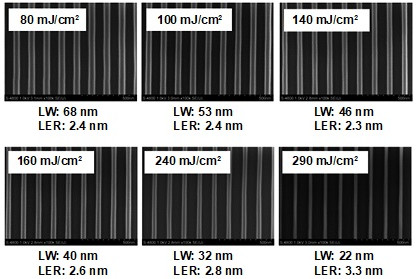
图4 上海光源用户基于软X射线干涉光刻线站开展的极紫外光刻胶性能评估工作


 下载:
下载:

