基于嵌段共聚物导向自组装的亚10纳米光刻工艺
-
摘要:
综述 ● 开放获取阅读更多
1.文章导读基于嵌段共聚物的导向自组装(Directed Self Assembly, DSA)是一种极具潜力的图形化工艺,通过分子自组装实现高分辨率图案化,可打破传统光刻的衍射极限,有望在下一代光刻技术(Next-Generation Lithography)中得到应用。该技术基于嵌段共聚物(BCPs)内部组成不同聚合物链段之间的热力学不相容产生的微相分离现象,使得BCPs能够一定条件下进行可控自组装,得到特定排列的BCPs薄膜。将导向自组装与其他光刻技术相结合,如极紫外光刻(Extreme Ultraviolet, EUV)和浸没式光刻,能够极大地提高加工结构的分辨率和器件密度。导向自组装技术目前已应用于场效应晶体管(Field-Effect Transistor, FET)、存储器件、数字图案化介质、光电子器件等的加工中,实现高密度集成和高效率低成本制造。最近,复旦大学信息科学与技术学院的熊诗圣课题组在《极端制造》期刊(International Journal of Extreme Manufacturing, IJEM)上发表以《基于嵌段共聚物导向自组装的亚10纳米光刻工艺》为题的综述文章,系统地阐述了DSA技术的研究背景、影响因素及相关应用。
2.研究背景在芯片制程度愈发接近物理极限的今天,国际半导体技术路线图(International Technology Roadmap for Semiconductors, ITRS)和国际器件与系统路线图(International Roadmap for Devices and Systems, IRDS)将基于BCPs的导向自组装技术与EUV和多重曝光技术共同列为实现下一代光刻技术突破的潜在技术,如图1所示。然而,EUV光刻的最高分辨率约15纳米左右,且设备、维护以及运作成本极高;多重曝光技术虽然位列下一代光刻的潜在技术中,但其也存在成本和多掩膜对准问题;此外,电子束光刻(EBL)虽然也能实现亚10 nm分辨率加工,但其效率问题制约了其在产业界的应用。而DSA技术能够实现低成本高效率的图案化加工,且其分辨率甚至超出了逻辑器件制造的需求。该技术基于BCPs分子内部不同聚合物链段部分之间在退火过程中的热力学不兼容,通过模版诱导自组装得到各种图案化结构,并由于每个BCP分子组成链段之间用共价键相连接使得该微相分离现象被限域在纳米尺度。通过对中性衬底进行化学修饰或预置引导图案模版,可控制BCPs组装成特定取向排列的结构,后续去除BCPs其中一种链段并保留另一种,即可完成BCPs的图案化加工(DSA中BCPs组成块体一般为两种)。熊诗圣研究员对影响DSA的因素以及DSA技术的应用进行了详细的论述。

图1. 国际半导体技术发展路线图(2015年版)
3.DSA的影响因素
Flory-Huggins参数 χ:BCP中最重要的性质是其组成嵌段之间的热力学不兼容,该性质用Flory-Huggins参数χ表示。BCP之间的微畴间距用全周期尺寸L0描述,L0为χ与聚合度 N 的相应正指数幂(指数小于1)的乘积,其中N直接决定了最终所得结构特征尺寸的大小。BCP的微相分离需要满足χN的值大于10.5,因此,为将特征尺寸缩小至亚10 nm尺度,则需要更小的N值,进而需要高χ值的BCPs,这是以往常用低χ值的PS-b-PMMA所难以达到的(层状PS-b-PMMA自组装形成的最小线宽约11纳米左右)。
熊诗圣研究员总结了近年来多种用作10 nm图案化的高χ值的BCPs合成及组装方法,包括有机(PS-b-PTMC、PS-b-PPC、PS-b-PLGA、PS-b-PTFEAs、PVBD-b-PDSS、PS-b-PMA)和无机(POSS、PFS、PTMSS、PDMS)BCPs,图2为利用PS-b-PLGA的导向自组装技术在不同温度下制备的不同周期光栅结构。
新型的高χ值的BCPs具备较大的热力学不兼容性,使得其更难发生自组装进而形成微畴方向与衬底垂直的结构,且高χ值的BCPs大多对高温敏感,传统热退火步骤难以兼容此类BCPs的自组装。针对此问题,开发了溶剂蒸汽退火技术(Solvent Vapor Annealing, SVA)。SVA能够使DSA在较低的温度条件下进行,避免了BCPs的高温热分解。在SVA过程中,由于BCPs的溶胀和收缩都会导致χ值发生一定变化;再而,SVA能够减小BCP中链段之间的表面能差,更容易形成垂直于衬底的微畴;利用溶液作为退火剂还可以提高分子的扩散率,使得BCPs更容易达到平衡态,最终降低结构的缺陷率;此外利用SVA还可以通过改变溶剂种类以及溶剂配比来实现BCP形貌的控制。
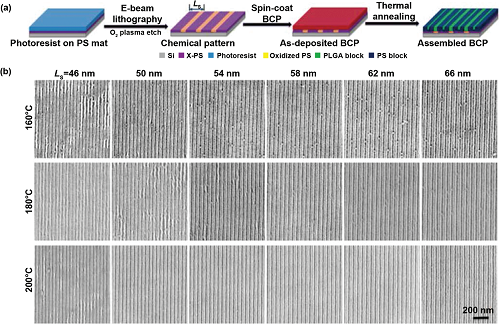
图2. (a)利用PS-b-PLGA嵌段共聚物的DSA技术制备光栅结构示意图及(b)在不同周期的引导模版和不同退火温度下的DSA结果的SEM图

图3. 溶剂退火工作腔体示意图。氮气作为丙酮溶液喷雾器的载体气体,并通过另外的氮气通道稀释丙酮蒸汽,在溶剂退火腔体内配置了光谱反射计监测BCP膜厚
除SVA方法外,通过顶部覆盖层热退火和其他退火方式:如激光退火、微波退火也能实现BCP薄膜的组装。
图案转移技术:BCP在完成微相分离形成特定表面形貌后,需要后续对BCP中的某一种相进行选择性刻蚀,保留另一种相的图形结构作为抗蚀掩模。随着DSA光刻的精度需求提高到亚10 nm尺度,对BCP的刻蚀对比度提出了更高的要求,熊诗圣研究员着重介绍了在该尺度下常用的BCP刻蚀方式。
反应离子束刻蚀(RIE)是刻蚀无机-有机组合BCP的有效方法,具有极高的刻蚀对比度,但由于无机元素的引入会带来器件的污染和后续去除困难等问题,因此,运用RIE刻蚀有机-有机链段组合的BCP仍是一项艰巨的挑战。在顺序渗透合成技术(Sequential Infiltration Synthesis, SIS)中,要求BCP中的一种链段能够选择性进行原子层沉积(Atomic Layer Deposition, ALD)生长金属氧化物,另一块体作为反应限制物,刻蚀聚合物后得到抗刻蚀能力极强的金属氧化物掩模。利用SIS技术极大地提高了全有机组合高χ值的BCPs的可加工性。溶脱(Lift-off)工艺在BCP刻蚀中也得以应用,在完成选择性刻蚀后,通过金属沉积再进行lift-off得到互补图案,但相对于其他两种方法,lift-off需要引入更多的工序使得可靠性不如RIE和SIS,其更多应用在功能材料的纳米点或纳米线的制备上。
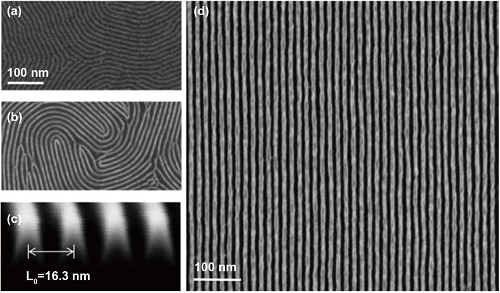
图4. SIS提高图案转移效果。(a)为在硅衬底上经过两次循环沉积后的指纹状结构SEM图,(b)为氧等离子刻蚀聚合物后的SEM图,(c)为其对应的截面图,(d)为硅衬底上通过SIS制备的光栅结构
4.DSA技术的应用在数年前,比利时微电子研究中心(IMEC)就开发了12英寸晶圆尺寸的DSA工业生产线。在开发过程中IMEC发现控制DSA的缺陷是极具挑战性的,其中主要的缺陷在于相邻线条间的位错和桥接,经过系统的动力学研究,最终可以实现每平方厘米的缺陷数量在10个以下,使得DSA能够真正应用到批量生产中。

图5. 利用BCP-DSA技术制备Fin-FET中的Fin结构原理示意
DSA作为高分辨率高效率低成本的纳米图案化技术,在制备高密度Cross-bar阵列(用于神经形态计算)和集成电路后段连线工艺(Back End of Line, BEOL)方面具备极大潜力。到目前为止,基于BCPs的DSA技术已经应用到各种半导体器件的生产中,如鳍式场效应晶体管(Fin-FET)(如图5所示)、存储器件(如图6所示)、分立式图形化存储媒介以及光电子器件。总而言之,运用DSA技术得到各种复杂的结构,在器件制备、化学和生物等领域(溶剂过滤和药物传输)都将得到重要应用。

图6. BCPs-DSA技术制备的SiOx纳米点阵结构的NiO忆阻存储器件结构示意图。(a)忆阻器器件示意图。(b)制备的忆阻器阵列的光学显微镜图。(c)器件的截面图。


 下载:
下载:

